
等离子体增强化学气相沉积系统
等离子体增强化学气相沉积系统(PECVD)是一种用于薄膜
半导体材料制备的高性能设备,能够在较低温度下借助等离子体的高活性促进化学反应,沉积出高质量的薄膜。该系统可沉积SiO₂、Si₃N₄、类金刚石薄膜、硬质薄膜和光学薄膜等,最大沉积尺寸达12英寸。系统配备射频淋浴源、空心阴极高密度等离子体源、感应耦合等离子体源或微波等离子体源,支持最高800°C的加热温度,均匀性优于±3%,并具备预抽真空室和自动晶片装卸功能,实现全自动控制。
PECVD:是借助微波或射频等使含有薄膜组成原子的气体电离,在局部形成等离子体,而等离子体化学活性很强,很容易发生反应,在基片上沉积出所期望的薄膜。为了使化学反应能在较低的温度下进行,利用了等离子体的活性来促进反应,因而这种CVD称为等离子体增强化学气相沉积(PECVD).
我司按照客户不同的应用需求,提供高质量的PECVD满足不同的研究生产需求。
我司提供的PECVD系统可以沉积高质量SiO2薄膜、Si3N4薄膜、类金刚石薄膜、硬质薄膜、光学薄膜等。最大沉积尺寸为12英寸。
通常选用射频淋浴源(RF)或带有不规则气体分布的空心阴极射频等离子体源作为反应源产生等粒子体。
部分PECVD可以升级到PECVD & 反应离子蚀刻双功能系统(带ICP源)。
系统参数:
腔体极限真空度:10-7 torr;
等粒子源: 射频淋浴源(RF)、空心阴极高密度等离子体源(HCD)、感应耦合等离子体源(ICP)或微波等离子体源, VHF(甚高频)电源
衬体直径:最大12” (300 mm)直径
带RF偏压的衬底托;
加热温度:最高800°C;
最高可达8路MFC和多样化的气体选择;
均匀性:≤±3%;
预抽真空室和自动晶片装卸门;
全自动控制;
应用领域:
等离子诱导表面改性;
等离子清洗;
等离子聚合;
SiO2, Si3N4, DLC及其它薄膜;

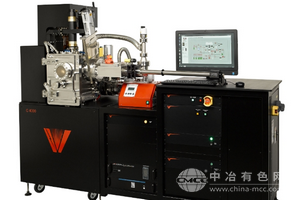
 697
697 





