
全部
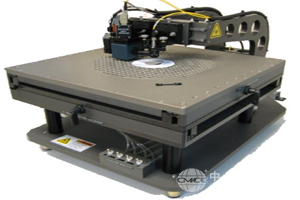
 110
110
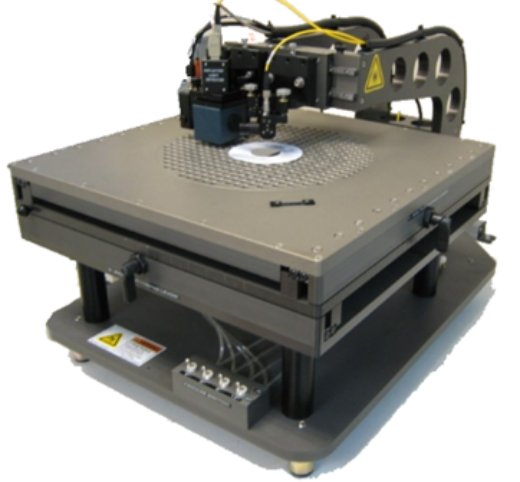
工作原理:
过红外激光束垂直照射样品表面,利用光束在材料内部及界面的多重反射形成干涉条纹,结合光谱分析算法计算薄膜或基底的厚度。
应用范围:
应用于晶圆厚度控制(如研磨、刻蚀工艺)、薄膜沉积监控(如氧化硅、氮化硅层)、MEMS 器件制造(沟槽深度、侧壁角度)、TSV(硅通孔)深度测量、LED 衬底厚度检测、环氧树脂封装层厚度分析等领域。其非接触式特性尤其适合测量带图案、有胶带或粘合在载体上的晶圆,以及柔性基底(如聚合物薄膜)的厚度变化。
产品技术参数:
测量方式:红外干涉(非接触式)
样本尺寸:标准支持 50mm、75mm、100mm、200mm、300mm 晶圆,可定制更大尺寸
厚度测量范围:单探头 15μm-780μm,双探头组合测量总厚度达 3mm
分辨率:10nm
重复性:单探头 0.1μm(1σ),双探头 0.8μm(1σ)
粗糙度测量范围:20Å-1000Å(RMS)
扫描方式:支持半自动/全自动 2D/3D 映射(Mapping)
真空吸附:100mmHg 真空度,适配高平整度样品
产品特点:
高精度与稳定性:采用双探头系统,可同步测量衬底厚度与图形层高度,分辨率达 10nm,重复性优于 0.1μm。
宽材料兼容性:覆盖硅、蓝宝石、碳化硅、玻璃、聚合物等红外透明材料,兼容有图案、凸起或键合的复杂结构。
非破坏性测量:避免传统接触式测量的划伤或形变风险,尤其适合薄晶圆(<100μm)及柔性基底。
多功能扩展:可选配沟槽深度、过孔尺寸、侧壁角度、粗糙度测量模块,支持 MEMS 及 TSV 工艺分析。
 举报 0
举报 0
 收藏 0
收藏 0
 反对 0
反对 0
 点赞 0
点赞 0



